半导体器件的可靠性和典型寿命通常可以用浴盆曲线来描述。浴盆曲线是一个产品寿命随时间的变化图形,由三个关键时期组成。第一个时期是早期失效期,特点是产品失效率起始值很高,随后急速下降。这一时期的失效主要是由产品设计、材料、工艺或制造过程中的缺陷和失误引起的。第二个时期正常使用期内的失效是随机失效,失效率低且相对恒定。第三个时期失效率逐渐增加,这是由于疲劳而导致的损耗失效。
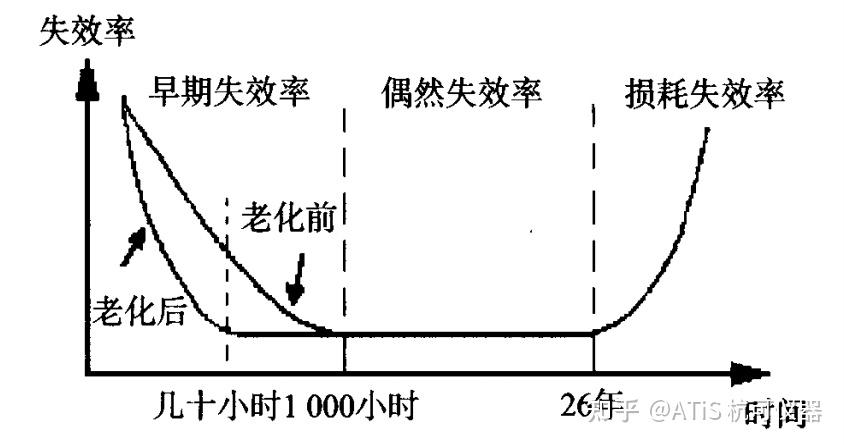
如果在加载额定电气条件的同时提高老化温度,就能使缺陷加速暴露而在较短时间内产生早期失效,这就是所谓的高温老化。老化试验的目的主要是剔除有缺陷的、可能发生早期失效的产品,是一种无损的筛选试验技术。集成电路的高温老化测试对集成电路的可靠性起着极为关键的作用。
老化测试是找出半导体器件使用寿命的一种估计方法。但是,老化测试会缩短测试设备的总寿命。即使有用的器件小时数不受影响,器件应力分布、效率、抗电过应力 EOS和静电放电 ESD能力也会受到长时间施加极端电压和温度的不利影响老化测试期间的时间。使用老化测试筛选的半导体组件会随着时间的推移而退化,需要更换。因此,老化过程间接增加了维护成本。
老化测试以高温老化为主,过程通常在 125℃ 的温度下进行,使用老化板配合IC老化测试座用于将半导体元件放入老化炉中,在其整个使用寿命期间可以提供给器件的偏置电压。
老化测试分为静态老化和动态老化。静态老化是半导体器件处于非工作模式下,半导体器件没有输入,其优点包括成本低和相简单的程序,成本相应会更低,但是缺点是老化测试设备上的所监控的电路节点不到实际数量的一半。静态老化一般来说也分多种情况,主要是温度恒定输入,供电以及监控部分都是mV和mA级别的供电,属于传统的老化测试。
动态老化半导体器件处于工作状态下,向半导体器件提供输入激励信号,通过侦测相关的信号来判定芯片或者说半导体器件在老化状态(或者说极端环境下)的工作状态,优点包括能够对内部电路施加更多压力和检测额外的故障,动态老化更贴近半导体器件的实际应用环境。动态老化又分为动态激励老化和功能性老化。动态激励老化由不同频率的时钟向被测器件进行动态激励,功能性老化则是模拟实际使用状态对被测器件施加信号。功能性老化试验能使被测器件更多的内部节点动作起来,被认为是探测有缺陷器件的一种更好的方法。
集成电路老化测试是在封装后进行的加速寿命测试,主要包括在高温高压条件下进行的电压测试,电流测试,时序特性测试和功能测试等。
芯片的引脚可以大致分为电源pin和信号pin两类。电源pin即电压稳定的管脚,如供电、偏置电压、GND等,其特点为在芯片工作过程中电压保持恒定值,因此可以简单地直接配置老化芯片所需的各规格供电电源(DPS)。
信号pin包含输入输出IO、时钟、片选、状态信号等,共同点是随芯片工作状态的不同其所需的电压信号有变化,因此使用FPGA控制输出所需的激励信号波形提供给待测芯片对应的引脚。通过外部激励向量或芯片内部自运行老化测试程序模块化、层次化地验证组合及时序逻辑以及各功能模块。激励向量和测试程序尽可能模拟实际工作状态,使电路内部的逻辑单元都有机会得到翻转,实现高覆盖率。老化机台及被老化芯片通常遵循如下的老化流程
测试时,老化机台配置老化芯片所需的各规格供电电源(DPS),通过其I/O口控制老化芯片加载老化测试程序,FPGA需外挂Flash加载程序,而DSP老化前需预烧录老化测试程序。程序加载完成后,老化机台启动被老化芯片的老化测试过程。最后,老化机台通过通信接口获取被老化芯片老化测试结果并控制结束单次老化流程。实际的老化试验(筛选)过程则是上述单次老化流程的循环执行并包括详细的数据记录和结果报告。